Растровый электронный микроскоп, или сокращенно РЭМ (англ. Scanning Electron Microscope - SEM), предназначен для получения изображения поверхности объекта с высоким (до 0,4 нм) пространственным разрешением, информации о составе, строении и некоторых других свойствах приповерхностных слоёв. Современный РЭМ позволяет работать в широком и плавно перестраиваемом диапазоне увеличений от 10 крат до 1000000 крат, что приблизительно в 500 раз превышает предел увеличения лучших оптических микроскопов. Существует огромное число выпускаемых десятками фирм разнообразных конструкций и типов РЭМ, оснащенных детекторами различных типов. Растровой электронной микроскопии используются практически во всех областях науки и промышленности, от биологии до материаловедения. Принцип работы основан на взаимодействии электронного пучка с исследуемым веществом. Электроны зонда (пучка) взаимодействуют с материалом образца и генерируют различные типы сигналов: вторичные электроны, обратноотраженные электроны, Оже-электроны, характеристическое рентгеновское излучение, катодолюминесценцию и т. д. Эти частицы и излучение являются носителями информации о топологии (рельефе) и материале образца.
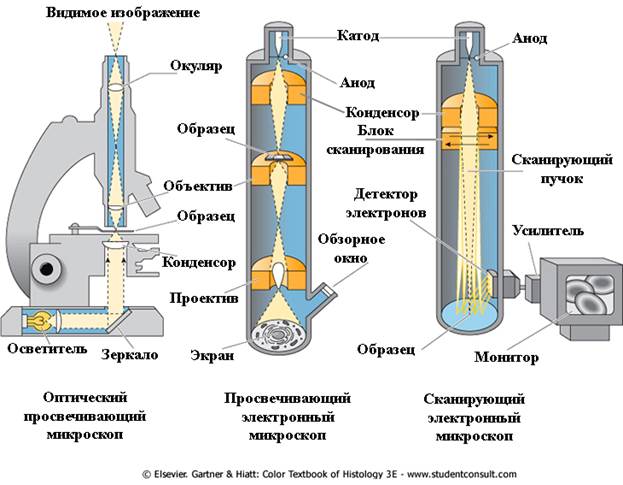
Основа сканирующего электронного микроскопа — электронная пушка и электрооптическая колонна, функции которых состоят в формировании остросфокусированного электронного зонда средних энергий (200 эВ — 50 кэВ) на поверхности образца. Из-за очень узкого электронного луча РЭМ обладают очень большой глубиной резкости, примерно на два порядка выше, чем у оптического микроскопа и позволяет получать четкие микрофотографии с характерным трехмерным эффектом для объектов со сложным рельефом. Это свойство РЭМ крайне полезно для понимания поверхностной структуры образца. Прибор обязательно должен быть оснащен вакуумной системой. Также в каждом РЭМ есть предметный столик, позволяющий перемещать образец минимум в трех направлениях. При взаимодействии электронов с объектом возникают несколько видов сигналов, каждый из которых улавливается специальным детектором. Соответственно, изображения, продуцируемые микроскопом, могут быть построены с использованием различных сигналов, часто нескольких сигналов одновременно (например, изображение во вторичных электронах, изображение в отраженных электронах, рентгеновское изображение (карта)).
Детектирование вторичных электронов
В качестве детектора вторичных электронов используется детектор Эверхарта-Торнли, позволяющий эффективно собирать электроны с энергией порядка 50 эВ. Изображения, выполненные при регистрации данным детектором, обладают меньшим разрешением, однако имеют контраст по среднему атомному номеру, то есть несут в себе большую долю информации о химическом составе и внутреннем строении приповерхностных слоев (глубиной до нескольких десятков нм).
Детектирование отражённых электронов
Некоторые модели микроскопов оснащены высокочувствительным полупроводниковым детектором обратнорассеянных электронов. Детектор смонтирован на нижней поверхности объективной линзы либо вводится на специальном стержне под полюсной наконечник. Данный детектор позволяет получить изображения топологии поверхности с большим разрешением.
Элементный микроанализ
Для анализа элементного состава применяется рентгеноспектральный микроанализ, в котором детектируется характеристическое рентгеновское излучение вещества, возникающее при облучении поверхности образца электронами. Существует энергодисперсионные (EDX) и волнодисперсионные (WDX) анализаторы. Первые обладают меньшим спектральным разрешением, но гораздо менее громоздки и просты в работе, нежели вторые.